Gruppe-III-Nitrid-basierte Schichtenfolge, Bauelement und Verfahren zur Herstellung
Erfinder:
Branchen:
Mess- & Mikrosystemtechnik, Werkstoffe & Werkstofftechnik
Angebote:
Lizensierung, Verkauf
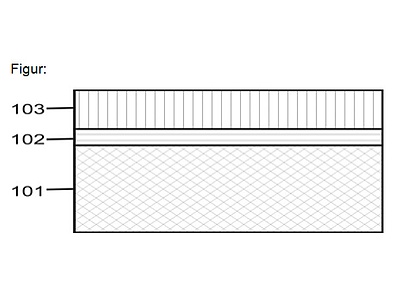
Die Erfindung betrifft eine Gruppe-III-Nitrid-basierte Schichtenfolge, sowie daraus hergestellte Bauelemente und ein Verfahren zu ihrer Herstellung. Hierbei wird eine Gruppe-III-Nitrid-basierte Schichtenfolge zur Verfügung gestellt, die zumindest eine AlxGayIn1-x-yN-basierte Keimschicht und eine AlxGayIn1-x-yN-Schicht auf einem Gruppe-IV-Substrat, mit x < 0.2 und x + y ≤ 1 umfasst, wobei die AlxGayIn1-x-yN -Keimschicht auf dem Substrat angeordnet ist und für x > 0.2 gilt.
Hergestellt werden kann solch eine Schicht mittels metallorganischer Gasphasenepitaxie (MOCVD, MOVPE) oder anderen Halbleiterbeschichtungsverfahren wie Molekularstrahlepitaxie MBE, Hydrid-gasphasenepitaxie (HVPE) oder Sputterverfahren, wobei hier der Prozess anhand des derzeit für die Gruppe-III-Nitride gebräuchlichen MOVPE-Verfahren einsetzbar ist. Dazu wird ein idealerweise vorher deoxidiertes und wasserstoffterminiertes Siliziumsubstrat in den MOVPE-Reaktor gelegt und unter Wasserstoff- oder Stickstoffträgergas auf ca. 670 °C geheizt. Der Beschichtungsprozess erfolgt dann ideal bei einem Druck um 100 mbar, nachdem das Trägergas auf Stickstoff umgeschaltet wurde, beginnend mit dem Einleiten von Trimethyl-Aluminium (TMAl), optional auch Trimethyl-Indium (TMIn) und ggf. eines n-Typ-Dotanden wie Silizium oder Germanium, z. B. mittels SiH4- oder GeH4-Zufuhr in den Reaktor für ca. 10 s, gefolgt von Ammoniak. Es wird dann für ca. 10 Minuten eine Schicht AlInN gewachsen, die ca. 10 nm dick ist. Der Dotand in der AlInN Schicht kann auch mit dem Ammoniak in den Reaktor geschaltet werden, dies ist mit identischem Ergebnis möglich.
In der Figur wird schematisch der Aufbau einer einfachen Zelle gezeigt. Das Substrat 101 ist hier entweder nur ein idealerweise p-leitender Träger oder eine n/p-Siliziumzelle, ideal mit einer oberen zur Schicht 102 weisenden p-leitenden Siliziumschicht. Die Schicht 102 ist dann die erfindungsgemäße AlGaInN-Schicht. Die Schicht 101 kann aber auch Substratmaterialien oder dünne Schichten auf einem Trägersubstrat im System SiGeC umfassen. Beispielsweise sind SiGe-Verbindungen bei einer Solarzelle interessant, um eine bessere Effizienz durch eine besser angepasste Bandlücke zu erzielen. Ideal ist eine Keimschicht im System AlxGayIn1-x-yN mit x > 20. Sie hat zudem vorzugsweise eine In-Konzentration zwischen 40-50 % bzw. 0.4 < 1-x-y < 0.5 und wenn ternär, also ohne Ga-Beimengung realisiert (y = 0), eine entsprechende Al-Konzentration von 60-50 % (0.5 ≤ x ≤ 0.6), welche zu einem geringen Anteil Ga von bis zu 20 % (y ≤ 0.2) enthalten kann.
Hergestellt werden kann solch eine Schicht mittels metallorganischer Gasphasenepitaxie (MOCVD, MOVPE) oder anderen Halbleiterbeschichtungsverfahren wie Molekularstrahlepitaxie MBE, Hydrid-gasphasenepitaxie (HVPE) oder Sputterverfahren, wobei hier der Prozess anhand des derzeit für die Gruppe-III-Nitride gebräuchlichen MOVPE-Verfahren einsetzbar ist. Dazu wird ein idealerweise vorher deoxidiertes und wasserstoffterminiertes Siliziumsubstrat in den MOVPE-Reaktor gelegt und unter Wasserstoff- oder Stickstoffträgergas auf ca. 670 °C geheizt. Der Beschichtungsprozess erfolgt dann ideal bei einem Druck um 100 mbar, nachdem das Trägergas auf Stickstoff umgeschaltet wurde, beginnend mit dem Einleiten von Trimethyl-Aluminium (TMAl), optional auch Trimethyl-Indium (TMIn) und ggf. eines n-Typ-Dotanden wie Silizium oder Germanium, z. B. mittels SiH4- oder GeH4-Zufuhr in den Reaktor für ca. 10 s, gefolgt von Ammoniak. Es wird dann für ca. 10 Minuten eine Schicht AlInN gewachsen, die ca. 10 nm dick ist. Der Dotand in der AlInN Schicht kann auch mit dem Ammoniak in den Reaktor geschaltet werden, dies ist mit identischem Ergebnis möglich.
In der Figur wird schematisch der Aufbau einer einfachen Zelle gezeigt. Das Substrat 101 ist hier entweder nur ein idealerweise p-leitender Träger oder eine n/p-Siliziumzelle, ideal mit einer oberen zur Schicht 102 weisenden p-leitenden Siliziumschicht. Die Schicht 102 ist dann die erfindungsgemäße AlGaInN-Schicht. Die Schicht 101 kann aber auch Substratmaterialien oder dünne Schichten auf einem Trägersubstrat im System SiGeC umfassen. Beispielsweise sind SiGe-Verbindungen bei einer Solarzelle interessant, um eine bessere Effizienz durch eine besser angepasste Bandlücke zu erzielen. Ideal ist eine Keimschicht im System AlxGayIn1-x-yN mit x > 20. Sie hat zudem vorzugsweise eine In-Konzentration zwischen 40-50 % bzw. 0.4 < 1-x-y < 0.5 und wenn ternär, also ohne Ga-Beimengung realisiert (y = 0), eine entsprechende Al-Konzentration von 60-50 % (0.5 ≤ x ≤ 0.6), welche zu einem geringen Anteil Ga von bis zu 20 % (y ≤ 0.2) enthalten kann.
weitere Informationen
Hintergrund
Gruppe-III-Nitrid-basierte Schichtfolgen sind aufgrund der direkten Bandlücke für eine Vielzahl von Anwendungen wie lichtemittierende Dioden und Hochspannungs- und Hochfrequenztransistoren hervorragend geeignet.
Dabei ist das direkte Wachstum von GaN Schichten auf Silizium und die Problematik des meltback etching bekannt, welches mit einer geringen Kristallqualität und dem üblicherweise auch hohen vertikalen Widerstand bei konventionellen Keimschichten einhergeht.
Dabei ist das direkte Wachstum von GaN Schichten auf Silizium und die Problematik des meltback etching bekannt, welches mit einer geringen Kristallqualität und dem üblicherweise auch hohen vertikalen Widerstand bei konventionellen Keimschichten einhergeht.
Marktpotential
Anwendung findet diese Gruppe-III-Nitrid-basierte Schichtenfolge beispielsweise bei einer Vielzahl von Bauelementen, wie zum Beispiel vertikalen Dioden als Schalter oder für LEDs aber auch für Solarzellen und dergleichen.
Entwicklungsstand
Der Vorteil dieser Schichtenanordnung besteht darin, dass gegenüber einer herkömmlichen Schichtenfolge mit einer Keimschicht mit Al < 20 % eine verbesserte Schichtqualität erzielt wird, zudem eine in der Literatur als meltback etching bezeichnete Reaktion von Gallium und Silizium unterdrückt wird und der elektrische Widerstand über die Grupp-III-Nitrid / Silizium Grenzfläche sehr gering ist. Dabei beziehen sich Prozentangaben der Gruppe-III-Elemente immer auf deren Anteil innerhalb der Gruppe-III-Elemente, d. h. die Summe der Gruppe-III-Elementkonzentration beträgt 100 %.
Dateien
Ansprechpartner Schutzrechte

Dr. rer. nat. Karen Henning
Universitätsplatz 2
39106
Magdeburg
Tel.:+49 391 6752091

